Diferencia entre revisiones de «Deposición de capas atómicas»
m Añadiendo plantilla Listaref |
Sin resumen de edición |
||
| Línea 4: | Línea 4: | ||
== Introducción == |
== Introducción == |
||
[[File:ALD_Periodic_Table_-_May_2019.png|vínculo=https://en.wikipedia.org/wiki/File:ALD_Periodic_Table_-_May_2019.png|miniaturadeimagen|300x300px|An overview of the materials synthesized by ALD with 1 or more publications describing the process, an up-to-date figure can be obtained online <ref name="ALDDatabase">{{cite journal|url=https://atomiclimits.com/alddatabase/|title=ALD Database|last1=Kessels|first1=W.M.M.|publisher=Eindhoven University of Technology|doi=10.6100/alddatabase|year=2019}}</ref> under the [[:en:Creative_Commons_license|Creative Commons license]] for general use.]] |
|||
Durante el proceso de deposición de capas atómicas, se forma una película sobre un sustrato exponiendo su superficie a especies gaseosas alternas (normalmente denominadas [[Precursor químico|precursores]] o reactivos). A diferencia de la deposición química en fase vapor, los precursores nunca están presentes simultáneamente en el reactor, sino que se introducen como una serie de pulsos secuenciales no solapados. En cada uno de estos pulsos, las moléculas precursoras reaccionan con la superficie de forma autolimitada, de modo que la reacción termina cuando se consumen todos los sitios disponibles en la superficie. Por consiguiente, la cantidad máxima de material depositado en la superficie tras una única exposición a todos los precursores (lo que se denomina ciclo ALD) viene determinada por la naturaleza de la interacción precursor-superficie |
Durante el proceso de deposición de capas atómicas, se forma una película sobre un sustrato exponiendo su superficie a especies gaseosas alternas (normalmente denominadas [[Precursor químico|precursores]] o reactivos). A diferencia de la deposición química en fase vapor, los precursores nunca están presentes simultáneamente en el reactor, sino que se introducen como una serie de pulsos secuenciales no solapados. En cada uno de estos pulsos, las moléculas precursoras reaccionan con la superficie de forma autolimitada, de modo que la reacción termina cuando se consumen todos los sitios disponibles en la superficie. Por consiguiente, la cantidad máxima de material depositado en la superficie tras una única exposición a todos los precursores (lo que se denomina ciclo ALD) viene determinada por la naturaleza de la interacción precursor-superficie.<ref name=":4">{{Cite journal|title=Surface chemistry of atomic layer deposition: A case study for the trimethylaluminum/water process|date=15 June 2005|journal=Journal of Applied Physics|volume=97|issue=12|pages=121301–121301–52|bibcode=2005JAP....97l1301P|doi=10.1063/1.1940727|first=Riikka L.|last=Puurunen}}</ref><ref name=":42">{{Cite journal|title=Surface chemistry of atomic layer deposition: A case study for the trimethylaluminum/water process|date=15 June 2005|journal=Journal of Applied Physics|volume=97|issue=12|pages=121301–121301–52|bibcode=2005JAP....97l1301P|doi=10.1063/1.1940727|first=Riikka L.|last=Puurunen}}</ref> Variando el número de ciclos es posible cultivar materiales de manera uniforme y con gran precisión en sustratos arbitrariamente complejos y grandes. |
||
ALD es un método de deposición con un gran potencial para producir películas muy finas y conformadas con control del espesor y la composición de las películas posible a nivel atómico. Una de las principales razones del reciente interés por este método son las posibilidades que ofrece para reducir la escala de los dispositivos microelectrónicos de acuerdo con la [[ley de Moore]]. El ALD es un campo de investigación muy activo, con cientos de procesos diferentes publicados en la literatura científica, |
ALD es un método de deposición con un gran potencial para producir películas muy finas y conformadas con control del espesor y la composición de las películas posible a nivel atómico. Una de las principales razones del reciente interés por este método son las posibilidades que ofrece para reducir la escala de los dispositivos microelectrónicos de acuerdo con la [[ley de Moore]]. El ALD es un campo de investigación muy activo, con cientos de procesos diferentes publicados en la literatura científica,<ref name=":4" /><ref name=":42" /> <ref name=":5">{{Cite journal|title=Crystallinity of inorganic films grown by atomic layer deposition: Overview and general trends|last1=Miikkulainen|first1=Ville|last2=Leskelä|first2=Markku|date=14 January 2013|journal=Journal of Applied Physics|volume=113|issue=2|pages=021301–021301–101|bibcode=2013JAP...113b1301M|doi=10.1063/1.4757907|last3=Ritala|first3=Mikko|last4=Puurunen|first4=Riikka L.}}</ref>aunque algunos de ellos presentan comportamientos que se alejan del proceso ALD ideal.<ref name=":5" /> Actualmente existen varios artículos de revisión exhaustivos que ofrecen un resumen de los procesos ALD publicados, entre los que se incluyen los trabajos de Puurunen,<ref name=":0">{{cite journal|title=Surface chemistry of atomic layer deposition: A case study for the trimethylaluminum/water process|last1=Puurunen|first1=Riikka L.|date=15 June 2005|journal=Journal of Applied Physics|volume=97|issue=12|pages=121301–121301–52|bibcode=2005JAP....97l1301P|doi=10.1063/1.1940727}}</ref> Miikkulainen ''et al'', <ref name=":5" /> Knoops ''et al''.,<ref>{{cite journal|url=https://research.tue.nl/nl/publications/9b93d7e7-a0d8-4924-af34-331f63694fee|title=Status and prospects of plasma-assisted atomic layer deposition|last1=Knoops|first1=Harm C. M.|last2=Faraz|first2=Tahsin|date=May 2019|journal=Journal of Vacuum Science & Technology A|volume=37|issue=3|pages=030902|bibcode=2019JVSTA..37c0902K|doi=10.1116/1.5088582|last3=Arts|first3=Karsten|last4=Kessels|first4=Wilhelmus M. M. (Erwin)|s2cid=108003079|doi-access=free}}</ref>y Mackus & Schneider ''et al''.<ref>{{cite journal|title=Synthesis of Doped, Ternary, and Quaternary Materials by Atomic Layer Deposition: A Review|last1=Mackus|first1=Adriaan J. M.|last2=Schneider|first2=Joel R.|date=10 December 2018|journal=Chemistry of Materials|volume=31|issue=4|pages=1142–1183|doi=10.1021/acs.chemmater.8b02878|last3=MacIsaac|first3=Callisto|last4=Baker|first4=Jon G.|last5=Bent|first5=Stacey F.|s2cid=104385650}}</ref> También está disponible en línea una base de datos interactiva de procesos ALD impulsada por la comunidad<ref name="ALDDatabase" /> que genera una visión general actualizada en forma de tabla periódica anotada. |
||
La técnica hermana de la deposición de capas atómicas, la [[deposición de capas moleculares]] (LDM), utiliza precursores orgánicos para depositar [[Polímero|polímeros]]. Combinando las técnicas ALD/(LDM, es posible fabricar películas híbridas altamente conformadas y puras para muchas aplicaciones. |
La técnica hermana de la deposición de capas atómicas, la [[deposición de capas moleculares]] (LDM), utiliza precursores orgánicos para depositar [[Polímero|polímeros]]. Combinando las técnicas ALD/(LDM, es posible fabricar películas híbridas altamente conformadas y puras para muchas aplicaciones. |
||
| Línea 13: | Línea 14: | ||
== Mecanismos de reacción superficial == |
== Mecanismos de reacción superficial == |
||
En un proceso ALD prototípico, un sustrato se expone a dos reactivos A y B de forma secuencial y no solapada. A diferencia de otras técnicas, como la [[Deposición química de vapor|deposición química en fase vapor]] (CVD), en las que el crecimiento de la capa fina se produce de forma continua, en el proceso ALD cada reactivo reacciona con la superficie de forma autolimitada: las moléculas reactivas sólo pueden reaccionar con un número finito de sitios reactivos de la superficie. Una vez que se han consumido todos esos sitios en el reactor, el crecimiento se detiene. Las moléculas reactivas restantes se eliminan y sólo entonces se introduce el reactivo B en el reactor. Mediante exposiciones alternas de A y B, se deposita una fina película. Este proceso se muestra en la figura lateral. Por consiguiente, cuando se describe un proceso ALD se hace referencia tanto a los tiempos de dosis (el tiempo que una superficie está expuesta a un precursor) como a los tiempos de purga (el tiempo que transcurre entre las dosis para que el precursor evacúe la cámara) para cada precursor. La secuencia dosis-purga-dosis-purga de un proceso ALD binario constituye un ciclo ALD. Además, en lugar de utilizar el concepto de tasa de crecimiento, los procesos de ALD se describen en términos de su crecimiento por ciclo[ |
En un proceso ALD prototípico, un sustrato se expone a dos reactivos A y B de forma secuencial y no solapada. A diferencia de otras técnicas, como la [[Deposición química de vapor|deposición química en fase vapor]] (CVD), en las que el crecimiento de la capa fina se produce de forma continua, en el proceso ALD cada reactivo reacciona con la superficie de forma autolimitada: las moléculas reactivas sólo pueden reaccionar con un número finito de sitios reactivos de la superficie. Una vez que se han consumido todos esos sitios en el reactor, el crecimiento se detiene. Las moléculas reactivas restantes se eliminan y sólo entonces se introduce el reactivo B en el reactor. Mediante exposiciones alternas de A y B, se deposita una fina película. Este proceso se muestra en la figura lateral. Por consiguiente, cuando se describe un proceso ALD se hace referencia tanto a los tiempos de dosis (el tiempo que una superficie está expuesta a un precursor) como a los tiempos de purga (el tiempo que transcurre entre las dosis para que el precursor evacúe la cámara) para cada precursor. La secuencia dosis-purga-dosis-purga de un proceso ALD binario constituye un ciclo ALD. Además, en lugar de utilizar el concepto de tasa de crecimiento, los procesos de ALD se describen en términos de su crecimiento por ciclo.<ref>[https://www.youtube.com/watch?v=KOEsgZU1sts "How Atomic Layer Deposition Works"]. Youtube (2011).</ref> |
||
En ALD, debe dejarse el tiempo suficiente en cada paso de la reacción para que pueda alcanzarse una densidad de adsorción completa. Cuando esto ocurre, el proceso ha alcanzado la saturación. Este tiempo dependerá de dos factores clave: la presión del precursor y la probabilidad de adherencia |
En ALD, debe dejarse el tiempo suficiente en cada paso de la reacción para que pueda alcanzarse una densidad de adsorción completa. Cuando esto ocurre, el proceso ha alcanzado la saturación. Este tiempo dependerá de dos factores clave: la presión del precursor y la probabilidad de adherencia.<ref name="book">{{cite book|author1=Butt, Hans-Jurgen|author2=Graf, Karlheinz|author3=Kappl, Michael|title=Physics and Chemistry of Interfaces|edition=Third, Revised|isbn=978-3-527-41216-7|year=2013|publisher=John Wiley & Sons}}</ref> Por tanto, la tasa de adsorción por unidad de superficie puede expresarse como: |
||
<math> {R_{abs}} = S*F</math> |
|||
| ⚫ | Donde R es la tasa de adsorción, S es la probabilidad de adherencia y F es el flujo molar incidente.<ref>{{cite web|url=http://www.chem.qmul.ac.uk/surfaces/scc/scat2_3.htm|title=2.3 Adsorption Kinetics – The Rate of Adsorption|website=www.chem.qmul.ac.uk}}</ref> Sin embargo, una característica clave del ALD es que la S cambiará con el tiempo, a medida que más moléculas hayan reaccionado con la superficie esta probabilidad de adherencia será menor hasta alcanzar un valor de cero una vez alcanzada la saturación. |
||
| ⚫ | Los detalles específicos sobre los mecanismos de reacción dependen en gran medida del proceso ALD concreto. Con cientos de procesos disponibles para depositar [[Óxido|óxidos]], [[Metal|metales]], [[Nitruro|nitruros]], [[Sulfuro|sulfuros]], [[Calcogenuro|calcogenuros]] y materiales [[Flúor|fluorados]],<ref name=":5" />el desentrañamiento de los aspectos mecanísticos de los procesos ALD es un campo de investigación activo.<ref name="GeorgeOverview3">{{cite journal|title=Atomic Layer Deposition: An Overview|last1=George|first1=S.M.|journal=Chem. Rev.|volume=110|issue=1|pages=111–131|doi=10.1021/cr900056b|pmid=19947596|year=2010}}</ref> A continuación se muestran algunos ejemplos representativos. |
||
| ⚫ | Donde R es la tasa de adsorción, S es la probabilidad de adherencia y F es el flujo molar incidente. |
||
| ⚫ | Los detalles específicos sobre los mecanismos de reacción dependen en gran medida del proceso ALD concreto. Con cientos de procesos disponibles para depositar [[Óxido|óxidos]], [[Metal|metales]], [[Nitruro|nitruros]], [[Sulfuro|sulfuros]], [[Calcogenuro|calcogenuros]] y materiales [[Flúor|fluorados]], |
||
=== ALD térmica === |
=== ALD térmica === |
||
Mecanismo propuesto para la ALD de Al<sub>2</sub>O<sub>3</sub> durante la a) reacción TMA b) reacción H<sub>2</sub>O |
[[File:Al2O3_Reaction_Mechanism_for_ALD.png|vínculo=https://en.wikipedia.org/wiki/File:Al2O3_Reaction_Mechanism_for_ALD.png|miniaturadeimagen|Mecanismo propuesto para la ALD de Al<sub>2</sub>O<sub>3</sub> durante la, a) reacción TMA, b) reacción H<sub>2</sub>O]] |
||
| ⚫ | La ALD térmica requiere temperaturas que oscilan entre la temperatura ambiente (~20°C) y los 350°C para el intercambio de [[Ligando|ligandos]] o las reacciones superficiales de tipo combustión.<ref>{{Cite thesis|last=Güder|first=Firat|url=https://freidok.uni-freiburg.de/data/8581|title=Atomlagenabscheidung unterstützt Nanostrukturelle Transformationen|publisher=University of Freiburg|year=2012|location=|type=Doctoral thesis|at=Front cover image|language=de|trans-title=Atomic layer deposition assisted nanostructural transformations}}</ref> Se produce mediante reacciones superficiales, lo que permite un control preciso del espesor independientemente de la geometría del sustrato (sujeto a la relación de aspecto) y del diseño del reactor[1]. |
||
| ⚫ | La ALD térmica requiere temperaturas que oscilan entre la temperatura ambiente (~20°C) y los 350°C para el intercambio de [[Ligando|ligandos]] o las reacciones superficiales de tipo combustión |
||
La síntesis de Al<sub>2</sub>O<sub>3</sub> a partir de [[trimetilaluminio]] (TMA) y agua es uno de los ejemplos de ALD térmico más conocidos. Durante la exposición al TMA, el TMA se quimisorbe disociativamente en la superficie del sustrato y el TMA restante se bombea fuera de la cámara. La quimisorción disociativa del TMA deja una superficie cubierta de AlCH<sub>3</sub>. A continuación, la superficie se expone a vapor de H<sub>2</sub>O, que reacciona con el -CH<sub>3</sub> superficial formando CH<sub>4</sub> como subproducto de la reacción y dando lugar a una superficie de Al<sub>2</sub>O<sub>3</sub> hidroxilada[1]. |
La síntesis de Al<sub>2</sub>O<sub>3</sub> a partir de [[trimetilaluminio]] (TMA) y agua es uno de los ejemplos de ALD térmico más conocidos. Durante la exposición al TMA, el TMA se quimisorbe disociativamente en la superficie del sustrato y el TMA restante se bombea fuera de la cámara. La quimisorción disociativa del TMA deja una superficie cubierta de AlCH<sub>3</sub>. A continuación, la superficie se expone a vapor de H<sub>2</sub>O, que reacciona con el -CH<sub>3</sub> superficial formando CH<sub>4</sub> como subproducto de la reacción y dando lugar a una superficie de Al<sub>2</sub>O<sub>3</sub> hidroxilada[1]. |
||
| Línea 34: | Línea 34: | ||
=== ALD espacial === |
=== ALD espacial === |
||
En el ALD temporal, las dosis separadas de precursor y co-reactivo se separan en el tiempo mediante un paso de purga. En cambio, en el ALD espacial (s-ALD), estos gases se suministran en lugares diferentes, por lo que están separados en el espacio. En la s-ALD a presión atmosférica, el precursor y el co-reactivo se suministran de forma continua y están separados entre sí por una cortina de gas para evitar reacciones en fase gaseosa. Dicha cortina de gas suele consistir en posiciones de inyección y escape de nitrógeno (véase la figura 1). A medida que un sustrato se desplaza por las distintas zonas de gas, se producen reacciones autolimitadas en la superficie del sustrato y tiene lugar el proceso de ALD. Dado que este proceso puede acelerarse fácilmente, la tasa de deposición para ALD espacial puede ser mucho mayor que para ALD convencional. Por ejemplo, para el ALD de Al<sub>2</sub>O<sub>3</sub>, la velocidad de deposición pasa de 100-300 nm por hora a 60 nm por minuto |
En el ALD temporal, las dosis separadas de precursor y co-reactivo se separan en el tiempo mediante un paso de purga. En cambio, en el ALD espacial (s-ALD), estos gases se suministran en lugares diferentes, por lo que están separados en el espacio. En la s-ALD a presión atmosférica, el precursor y el co-reactivo se suministran de forma continua y están separados entre sí por una cortina de gas para evitar reacciones en fase gaseosa. Dicha cortina de gas suele consistir en posiciones de inyección y escape de nitrógeno (véase la figura 1). A medida que un sustrato se desplaza por las distintas zonas de gas, se producen reacciones autolimitadas en la superficie del sustrato y tiene lugar el proceso de ALD. Dado que este proceso puede acelerarse fácilmente, la tasa de deposición para ALD espacial puede ser mucho mayor que para ALD convencional. Por ejemplo, para el ALD de Al<sub>2</sub>O<sub>3</sub>, la velocidad de deposición pasa de 100-300 nm por hora a 60 nm por minuto.<ref name=":0" /> |
||
La naturaleza en línea del ALD espacial lo hace adecuado para líneas de producción de gran volumen y producción rollo a rollo. En general, el s-ALD se ha empleado para aplicar barreras de permeación de humedad, capas de pasivación en células solares de silicio y capas funcionales en baterías. La química de los procesos ALD espaciales es comparable a la de los procesos ALD temporales típicos, y los materiales que se han explorado incluyen óxidos metálicos inorgánicos como Al<sub>2</sub>O<sub>3</sub>, ZnO (dopado con Al o Ga), SiO<sub>2</sub>, In<sub>2</sub>O<sub>3</sub>, InZnO, LIPON, Zn(O,S), SnOx y TiOx ,pero también pueden depositarse metales PMG (Pt, Ir, Ru). Además, las moléculas orgánicas pueden crecer en combinación con átomos inorgánicos para permitir la deposición de capas moleculares (MLD). Se ha demostrado la ALD espacial mejorada con plasma u ozono, que suele reducir las temperaturas de deposición necesarias. |
La naturaleza en línea del ALD espacial lo hace adecuado para líneas de producción de gran volumen y producción rollo a rollo. En general, el s-ALD se ha empleado para aplicar barreras de permeación de humedad, capas de pasivación en células solares de silicio y capas funcionales en baterías. La química de los procesos ALD espaciales es comparable a la de los procesos ALD temporales típicos, y los materiales que se han explorado incluyen óxidos metálicos inorgánicos como Al<sub>2</sub>O<sub>3</sub>, ZnO (dopado con Al o Ga), SiO<sub>2</sub>, In<sub>2</sub>O<sub>3</sub>, InZnO, LIPON, Zn(O,S), SnOx y TiOx ,pero también pueden depositarse metales PMG (Pt, Ir, Ru). Además, las moléculas orgánicas pueden crecer en combinación con átomos inorgánicos para permitir la deposición de capas moleculares (MLD). Se ha demostrado la ALD espacial mejorada con plasma u ozono, que suele reducir las temperaturas de deposición necesarias. |
||
| Línea 42: | Línea 42: | ||
=== ALD de metal === |
=== ALD de metal === |
||
El ALD de cobre metálico ha atraído mucha atención debido a la demanda de cobre como material de [[Interconexión (circuitos integrados)|interconexión]] y a la relativa facilidad con la que el cobre puede depositarse térmicamente |
El ALD de cobre metálico ha atraído mucha atención debido a la demanda de cobre como material de [[Interconexión (circuitos integrados)|interconexión]] y a la relativa facilidad con la que el cobre puede depositarse térmicamente.<ref name=":8">{{Cite journal|title=Precursors and chemistry for the atomic layer deposition of metallic first row transition metal films|last1=Knisley|first1=Thomas J.|last2=Kalutarage|first2=Lakmal C.|date=December 2013|journal=Coordination Chemistry Reviews|volume=257|issue=23–24|pages=3222–3231|doi=10.1016/j.ccr.2013.03.019|last3=Winter|first3=Charles H.}}</ref> El cobre tiene un [[Potencial normal de electrodo|potencial electroquímico estándar]] positivo<ref>{{Cite book|title=CRC handbook of chemistry and physics : a ready-reference book of chemical and physical data|date=2011|publisher=CRC Press|editor=Haynes, William M.|isbn=9781439855119|edition=92nd|location=Boca Raton, FL.|oclc=730008390}}</ref> y es el metal que se reduce más fácilmente de los metales de transición de la primera fila. Por ello, se han desarrollado numerosos procesos de ALD, incluyendo varios que utilizan gas hidrógeno como reactivo principal<ref name=":8" /><ref>{{Cite journal|title=Trends in Copper Precursor Development for CVD and ALD Applications|last1=Gordon|first1=Peter G.|last2=Kurek|first2=Agnieszka|date=2015|journal=ECS Journal of Solid State Science and Technology|volume=4|issue=1|pages=N3188–N3197|issn=2162-8769|doi=10.1149/2.0261501jss|last3=Barry|first3=Seán T.|s2cid=97668427|doi-access=free}}</ref>Idealmente, el ALD de cobre metálico debería realizarse a ≤100 °C para conseguir películas continuas con baja rugosidad superficial,<ref>{{Cite journal|title=Low Temperature Growth of High Purity, Low Resistivity Copper Films by Atomic Layer Deposition|last1=Knisley|first1=Thomas J.|last2=Ariyasena|first2=Thiloka C.|date=2011-10-25|journal=Chemistry of Materials|volume=23|issue=20|pages=4417–4419|issn=0897-4756|doi=10.1021/cm202475e|last3=Sajavaara|first3=Timo|last4=Saly|first4=Mark J.|last5=Winter|first5=Charles H.}}</ref>ya que temperaturas más altas pueden provocar la aglomeración del cobre depositado.<ref>{{Cite journal|title=Low-Temperature Atomic Layer Deposition of High Purity, Smooth, Low Resistivity Copper Films by Using Amidinate Precursor and Hydrogen Plasma|last1=Guo|first1=Zheng|last2=Li|first2=Hao|date=2015-09-08|journal=Chemistry of Materials|volume=27|issue=17|pages=5988–5996|issn=0897-4756|doi=10.1021/acs.chemmater.5b02137|last3=Chen|first3=Qiang|last4=Sang|first4=Lijun|last5=Yang|first5=Lizhen|last6=Liu|first6=Zhongwei|last7=Wang|first7=Xinwei}}</ref> |
||
Algunos metales pueden crecer por ALD mediante [[Reacción de eliminación|reacciones de eliminación]] de fluorosilano utilizando un [[Halogenuro|haluro metálico]] y un precursor de silicio (por ejemplo, [[Silano|SiH<sub>4</sub>]], Si<sub>2</sub>H<sub>6</sub>) como reactivos. Estas reacciones son muy exotérmicas debido a la formación de enlaces estables Si-F. |
Algunos metales pueden crecer por ALD mediante [[Reacción de eliminación|reacciones de eliminación]] de fluorosilano utilizando un [[Halogenuro|haluro metálico]] y un precursor de silicio (por ejemplo, [[Silano|SiH<sub>4</sub>]], Si<sub>2</sub>H<sub>6</sub>) como reactivos. Estas reacciones son muy exotérmicas debido a la formación de enlaces estables Si-F.<ref name="GeorgeOverview3" /> Entre los metales depositados por eliminación de fluorosilano se incluyen el wolframio<ref name=":9">{{Cite journal|title=Atomic layer deposition of tungsten using sequential surface chemistry with a sacrificial stripping reaction|last1=Klaus|first1=J.W|last2=Ferro|first2=S.J|date=February 2000|journal=Thin Solid Films|volume=360|issue=1–2|pages=145–153|bibcode=2000TSF...360..145K|doi=10.1016/S0040-6090(99)01076-7|last3=George|first3=S.M}}</ref> y el molibdeno.<ref>{{Cite journal|title=Molybdenum Atomic Layer Deposition Using MoF 6 and Si 2 H 6 as the Reactants|last1=Seghete|first1=D.|last2=Rayner|first2=G.B.|date=2011-04-12|journal=Chemistry of Materials|volume=23|issue=7|pages=1668–1678|issn=0897-4756|doi=10.1021/cm101673u|last3=Cavanagh|first3=A.S.|last4=Anderson|first4=V.R.|last5=George|first5=S.M.}}</ref> Como ejemplo, las reacciones superficiales para ALD de wolframio metálico utilizando WF<sub>6</sub> y Si<sub>2</sub>H<sub>6</sub> como reactivos pueden expresarse como.<ref name=":9" /><ref>{{Cite journal|title=Gas phase reaction products during tungsten atomic layer deposition using WF[sub 6] and Si[sub 2]H[sub 6]|last1=Grubbs|first1=R. K.|last2=Steinmetz|first2=N. J.|date=2004|journal=Journal of Vacuum Science & Technology B: Microelectronics and Nanometer Structures|volume=22|issue=4|pages=1811|bibcode=2004JVSTB..22.1811G|doi=10.1116/1.1767105|last3=George|first3=S. M.}}</ref> |
||
: WSiF<sub>2</sub>H* + WF<sub>6</sub> → WWF<sub>5</sub>* + SiF<sub>3</sub>H |
: WSiF<sub>2</sub>H* + WF<sub>6</sub> → WWF<sub>5</sub>* + SiF<sub>3</sub>H |
||
: WF<sub>5</sub>* + Si<sub>2</sub>H<sub>6</sub> → WSiF<sub>2</sub>H* + SiF<sub>3</sub>H + 2 H<sub>2</sub> |
: WF<sub>5</sub>* + Si<sub>2</sub>H<sub>6</sub> → WSiF<sub>2</sub>H* + SiF<sub>3</sub>H + 2 H<sub>2</sub> |
||
:La reacción global de ALD es |
:La reacción global de ALD es<ref name="GeorgeOverview3" /> |
||
WF<sub>6</sub> + Si<sub>2</sub>H<sub>6</sub> → W + SiF<sub>3</sub>H + 2 H<sub>2</sub>, ∆H = –181 kcal |
WF<sub>6</sub> + Si<sub>2</sub>H<sub>6</sub> → W + SiF<sub>3</sub>H + 2 H<sub>2</sub>, ∆H = –181 kcal |
||
La velocidad de crecimiento puede variar de 4 a 7 [[Ángstrom|Å]]/ciclo dependiendo de la temperatura de deposición (177 a 325 °C) y de la exposición del reactivo Si<sub>2</sub>H<sub>6</sub> (~10<sup>4</sup> a 10<sup>6</sup> L), factores que pueden influir en la inserción del Si<sub>2</sub>H<sub>6</sub> en los enlaces Si-H |
La velocidad de crecimiento puede variar de 4 a 7 [[Ángstrom|Å]]/ciclo dependiendo de la temperatura de deposición (177 a 325 °C) y de la exposición del reactivo Si<sub>2</sub>H<sub>6</sub> (~10<sup>4</sup> a 10<sup>6</sup> L), factores que pueden influir en la inserción del Si<sub>2</sub>H<sub>6</sub> en los enlaces Si-H<ref>{{Cite journal|title=Quartz crystal microbalance study of tungsten atomic layer deposition using WF6 and Si2H6|last1=Fabreguette|first1=F.H.|last2=Sechrist|first2=Z.A.|date=September 2005|journal=Thin Solid Films|volume=488|issue=1–2|pages=103–110|bibcode=2005TSF...488..103F|doi=10.1016/j.tsf.2005.04.114|last3=Elam|first3=J.W.|last4=George|first4=S.M.}}</ref><ref>{{Cite journal|title=Kinetics of the WF6 and Si2H6 surface reactions during tungsten atomic layer deposition|last1=Elam|first1=J.W|last2=Nelson|first2=C.E|date=May 2001|journal=Surface Science|volume=479|issue=1–3|pages=121–135|bibcode=2001SurSc.479..121E|doi=10.1016/S0039-6028(01)00969-4|last3=Grubbs|first3=R.K|last4=George|first4=S.M}}</ref>y dar lugar a una contribución del silicio CVD al crecimiento ALD del wolframio. |
||
El ALD térmico de muchos otros metales es un reto (o actualmente imposible) debido a sus potenciales electroquímicos muy negativos. Recientemente, la aplicación de nuevos agentes reductores fuertes ha dado lugar a los primeros informes sobre procesos de ALD térmico a baja temperatura para varios metales electropositivos. El cromo metálico se depositó utilizando un precursor de [[alcóxido]] de cromo y BH<sub>3</sub>(NHMe<sub>2</sub>) |
El ALD térmico de muchos otros metales es un reto (o actualmente imposible) debido a sus potenciales electroquímicos muy negativos. Recientemente, la aplicación de nuevos agentes reductores fuertes ha dado lugar a los primeros informes sobre procesos de ALD térmico a baja temperatura para varios metales electropositivos. El cromo metálico se depositó utilizando un precursor de [[alcóxido]] de cromo y BH<sub>3</sub>(NHMe<sub>2</sub>).<ref>{{Cite journal|title=Volatile and Thermally Stable Mid to Late Transition Metal Complexes Containing α-Imino Alkoxide Ligands, a New Strongly Reducing Coreagent, and Thermal Atomic Layer Deposition of Ni, Co, Fe, and Cr Metal Films|last1=Kalutarage|first1=Lakmal C.|last2=Martin|first2=Philip D.|date=2013-08-28|journal=Journal of the American Chemical Society|volume=135|issue=34|pages=12588–12591|issn=0002-7863|doi=10.1021/ja407014w|pmid=23947400|last3=Heeg|first3=Mary Jane|last4=Winter|first4=Charles H.}}</ref>Los metales titanio y estaño se cultivaron a partir de sus respectivos cloruros metálicos (MCl<sub>4</sub>, M = Ti, Sn) y un compuesto de anillo bis(trimetilsililo) de seis miembros.<ref>{{Cite journal|title=Thermal Atomic Layer Deposition of Titanium Films Using Titanium Tetrachloride and 2-Methyl-1,4-bis(trimethylsilyl)-2,5-cyclohexadiene or 1,4-Bis(trimethylsilyl)-1,4-dihydropyrazine|last1=Klesko|first1=Joseph P.|last2=Thrush|first2=Christopher M.|date=2015-07-28|journal=Chemistry of Materials|volume=27|issue=14|pages=4918–4921|issn=0897-4756|doi=10.1021/acs.chemmater.5b01707|last3=Winter|first3=Charles H.}}</ref> <ref>{{Cite journal|title=Thermal atomic layer deposition of Sn metal using SnCl 4 and a vapor phase silyl dihydropyrazine reducing agent|last1=Stevens|first1=Eric C.|last2=Mousa|first2=Moataz Bellah M.|date=November 2018|journal=Journal of Vacuum Science & Technology A|volume=36|issue=6|pages=06A106|bibcode=2018JVSTA..36fA106S|issn=0734-2101|doi=10.1116/1.5055212|last3=Parsons|first3=Gregory N.|s2cid=104844454}}</ref>El aluminio metálico se depositó utilizando un precursor de [[Hidruro|dihidruro]] de aluminio y AlCl<sub>3</sub>.<ref>{{Cite journal|title=Atomic Layer Deposition of Aluminum Metal Films Using a Thermally Stable Aluminum Hydride Reducing Agent|last1=Blakeney|first1=Kyle J.|last2=Winter|first2=Charles H.|date=2018-03-27|journal=Chemistry of Materials|volume=30|issue=6|pages=1844–1848|issn=0897-4756|doi=10.1021/acs.chemmater.8b00445}}</ref> |
||
=== ALD de SiO<sub>2</sub> catalizada === |
=== ALD de SiO<sub>2</sub> catalizada === |
||
[[Archivo:SiO2_Reaction_Mechanism.png|miniaturadeimagen|Mecanismo propuesto para la ALD de SiO<sub>2</sub> catalizada durante a) una reacción con SiCl<sub>4</sub> y b) una reacción H<sub>2</sub>O]] |
[[Archivo:SiO2_Reaction_Mechanism.png|miniaturadeimagen|Mecanismo propuesto para la ALD de SiO<sub>2</sub> catalizada durante a) una reacción con SiCl<sub>4</sub> y b) una reacción H<sub>2</sub>O]] |
||
El uso de catalizadores es de vital importancia para conseguir métodos fiables de ALD del SiO<sub>2</sub>. Sin catalizadores, las reacciones superficiales que conducen a la formación de SiO<sub>2</sub> suelen ser muy lentas y sólo se producen a temperaturas excepcionalmente altas. Los catalizadores típicos para la ALD de SiO<sub>2</sub> incluyen [[Teoría ácido-base de Lewis|bases de Lewis]] como NH<sub>3</sub> o piridina y SiO<sub>2</sub>; la ALD también puede iniciarse cuando estas bases de Lewis se acoplan con otros precursores de silicio como el tetraetoxisilano (TEOS) |
El uso de catalizadores es de vital importancia para conseguir métodos fiables de ALD del SiO<sub>2</sub>. Sin catalizadores, las reacciones superficiales que conducen a la formación de SiO<sub>2</sub> suelen ser muy lentas y sólo se producen a temperaturas excepcionalmente altas. Los catalizadores típicos para la ALD de SiO<sub>2</sub> incluyen [[Teoría ácido-base de Lewis|bases de Lewis]] como NH<sub>3</sub> o piridina y SiO<sub>2</sub>; la ALD también puede iniciarse cuando estas bases de Lewis se acoplan con otros precursores de silicio como el tetraetoxisilano (TEOS).<ref name="GeorgeOverview3" />Se cree que el enlace de hidrógeno se produce entre la base de Lewis y la especie superficial SiOH* o entre el reactivo basado en H<sub>2</sub>O y la base de Lewis. El oxígeno se convierte en un nucleófilo más fuerte cuando la base de Lewis se une por enlace de hidrógeno con la especie superficial SiOH* porque el enlace SiO-H se debilita de forma efectiva. Como tal, el átomo de Si electropositivo del reactivo SiCl<sub>4</sub> es más susceptible al ataque nucleofílico. Del mismo modo, el enlace de hidrógeno entre una base de Lewis y un reactivo H<sub>2</sub>O hace que el O electronegativo del H<sub>2</sub>O sea un nucleófilo fuerte capaz de atacar al Si en una especie superficial de SiCl* existente.<ref>{{cite journal|title=Surface Modification of Au/TiO<sub>2</sub> Catalysts by SiO<sub>2</sub> via Atomic Layer Deposition|last1=Brown|first1=S.|last2=Howe|first2=J.Y.|journal=The Journal of Physical Chemistry C|volume=112|issue=25|pages=9448–9457|doi=10.1021/jp801484h|last3=Ma|first3=Z.|last4=Et|year=2008}}</ref>El uso de un catalizador de base de Lewis es más o menos un requisito para la ALD del SiO<sub>2</sub>, ya que sin un catalizador de base de Lewis, las temperaturas de reacción deben superar los 325 °C y las presiones deben superar los 103 torr. Generalmente, la temperatura más favorable para realizar la ALD del SiO<sub>2</sub> es a 32 °C y una velocidad de deposición común es de 1,35 angstroms por secuencia de reacción binaria. A continuación se presentan dos reacciones superficiales para la ALD del SiO<sub>2</sub>, una reacción global y un esquema que ilustra la catálisis de la base de Lewis en la ALD de SiO<sub>2</sub>.Aplicaciones |
||
: Reacciones primarias en la superficie: |
: Reacciones primarias en la superficie: |
||
| Línea 74: | Línea 74: | ||
|- |
|- |
||
|ALD catalítica |
|ALD catalítica |
||
|>32 °C con catalizador de base Lewis<ref name=" |
|>32 °C con catalizador de base Lewis<ref name="GeorgeOverview3" /> |
||
|Óxidos metálicos (es decir TiO<sub>2</sub> ZrO<sub>2</sub>,SnO<sub>2</sub>)<ref name=" |
|Óxidos metálicos (es decir TiO<sub>2</sub> ZrO<sub>2</sub>,SnO<sub>2</sub>)<ref name="GeorgeOverview3" /> |
||
|(Metal)Cl<sub>4</sub>, H<sub>2</sub>O<ref name=" |
|(Metal)Cl<sub>4</sub>, H<sub>2</sub>O<ref name="GeorgeOverview3" /> |
||
|Capas de alto k-dieléctrico, capas protectoras, capas antirreflectantes, etc.<ref name="GeorgeOverview" /> |
|Capas de alto k-dieléctrico, capas protectoras, capas antirreflectantes, etc.<ref name="GeorgeOverview" /> |
||
|- |
|- |
||
|Al<sub>2</sub>O<sub>3</sub> ALD |
|Al<sub>2</sub>O<sub>3</sub> ALD |
||
|30–300 °C |
|30–300 °C |
||
|Al<sub>2</sub>O<sub>3</sub>, óxidos metálicos <ref name="Florian">{{cite journal|title= |
|Al<sub>2</sub>O<sub>3</sub>, óxidos metálicos <ref name="Florian">{{cite journal|title=Deposición de capas atómicas de alta velocidad de |
||
Al<sub>2</sub>Ol<sub>3</sub>para la pasivación superficial de células solares de Si|journal=Energy Procedia|volume=8|pages=1301–306|doi=10.1016/j.egypro.2011.06.140|author3=Gortzen, Roger|author4=Veith, Boris|author5=Brendel, Rolf|author6=Schmidt, Jan|year=2011|author1=Werner, Florian|author2=Stals, Walter}}</ref> |
|||
|(Metal)Cl<sub>4</sub>, H<sub>2</sub>O, Ti(OiPr)<sub>4</sub>, (Metal)(Et)<sub>2</sub><ref name=" |
|(Metal)Cl<sub>4</sub>, H<sub>2</sub>O, Ti(OiPr)<sub>4</sub>, (Metal)(Et)<sub>2</sub><ref name="GeorgeOverview3" /> |
||
|Capas dieléctricas, capas aislantes, etc., pasivaciones superficiales de células solares<ref name="Florian" /> |
|Capas dieléctricas, capas aislantes, etc., pasivaciones superficiales de células solares<ref name="Florian" /> |
||
|- |
|- |
||
| Línea 92: | Línea 93: | ||
|- |
|- |
||
|ALD en polímeros |
|ALD en polímeros |
||
|25–100 °C<ref name=" |
|25–100 °C<ref name="GeorgeOverview3" /> |
||
|Polímeros comunes (polietileno, PMMA, PP, PS, PVC, PVA, etc.)<ref name=" |
|Polímeros comunes (polietileno, PMMA, PP, PS, PVC, PVA, etc.)<ref name="GeorgeOverview3" /> |
||
|Al(CH<sub>3</sub>)<sub>3</sub>, H<sub>2</sub>O, M(CH<sub>3</sub>)<sub>3</sub><ref name=" |
|Al(CH<sub>3</sub>)<sub>3</sub>, H<sub>2</sub>O, M(CH<sub>3</sub>)<sub>3</sub><ref name="GeorgeOverview3" /> |
||
|Funcionalización de superficies poliméricas, creación de compuestos, barreras de difusión, etc.<ref name="GeorgeOverview" /> |
|Funcionalización de superficies poliméricas, creación de compuestos, barreras de difusión, etc.<ref name="GeorgeOverview" /> |
||
|- |
|- |
||
|ALD en partículas |
|ALD en partículas |
||
|25-100 °C para partículas de polímero, 100-400 °C |
|25-100 °C para partículas de polímero, 100-400 °C |
||
para partículas de metal/aleación<ref name=" |
para partículas de metal/aleación<ref name="GeorgeOverview3" /> |
||
|BN, ZrO<sub>2</sub>, CNTs, partículas poliméricas |
|BN, ZrO<sub>2</sub>, CNTs, partículas poliméricas |
||
|Gases diversos: Los reactores de lecho fluidizado se utilizan para permitir el recubrimiento de partículas individuales<ref name="GeorgeOverview" /> |
|Gases diversos: Los reactores de lecho fluidizado se utilizan para permitir el recubrimiento de partículas individuales<ref name="GeorgeOverview" /> |
||
| Línea 105: | Línea 106: | ||
|- |
|- |
||
|ALD mejorada por plasma o radicales para materiales ALD de un solo elemento |
|ALD mejorada por plasma o radicales para materiales ALD de un solo elemento |
||
|20–800 °C<ref>{{cite journal|title=Room-Temperature Atomic Layer Deposition of Platinum|last1=Mackus|first1=Adriaan J. M.|last2=Garcia-Alonso|first2=Diana|date=2013|journal=Chemistry of Materials|volume=25|issue=9|pages=1769–1774|doi=10.1021/cm400274n|last3=Knoops|first3=Harm C. M.|last4=Bol|first4=Ageeth A.|last5=Kessels|first5=Wilhelmus M. M.}}</ref |
|20–800 °C<ref name="GeorgeOverview3" /><ref>{{cite journal|title=Room-Temperature Atomic Layer Deposition of Platinum|last1=Mackus|first1=Adriaan J. M.|last2=Garcia-Alonso|first2=Diana|date=2013|journal=Chemistry of Materials|volume=25|issue=9|pages=1769–1774|doi=10.1021/cm400274n|last3=Knoops|first3=Harm C. M.|last4=Bol|first4=Ageeth A.|last5=Kessels|first5=Wilhelmus M. M.}}</ref> |
||
|Metales puros (por ej. Ta, Ti, Si, Ge, Ru, Pt), nitruros metálicos, (por ej. TiN, TaN, etc.)<ref name="GeorgeOverview" /> |
|Metales puros (por ej. Ta, Ti, Si, Ge, Ru, Pt), nitruros metálicos, (por ej. TiN, TaN, etc.)<ref name="GeorgeOverview" /> |
||
|Organometálicos, MH<sub>2</sub>C<sub>l2</sub>, terbutilimidotris(dietilamido)tántalo (TBTDET), bis(etilciclopentadienil)rutenio), NH<sub>3</sub><ref name="GeorgeOverview" /> |
|Organometálicos, MH<sub>2</sub>C<sub>l2</sub>, terbutilimidotris(dietilamido)tántalo (TBTDET), bis(etilciclopentadienil)rutenio), NH<sub>3</sub><ref name="GeorgeOverview" /> |
||
Revisión del 17:17 18 dic 2023
La deposición de capas atómicas (ALD por sus siglas en inglés) es una técnica de deposición de películas finas basada en el uso secuencial de un proceso químico en fase gaseosa; es una subclase de la deposición química en fase vapor. La mayoría de las reacciones de ALD utilizan dos sustancias químicas llamadas precursores (también denominadas "reactantes"). Estos precursores reaccionan con la superficie de un material de uno en uno de forma secuencial y autolimitada. Una fina película se deposita lentamente mediante la exposición repetida a los distintos precursores. La ALD es un proceso clave en la fabricación de dispositivos semiconductores y forma parte del conjunto de herramientas para sintetizar nanomateriales.
Introducción

Durante el proceso de deposición de capas atómicas, se forma una película sobre un sustrato exponiendo su superficie a especies gaseosas alternas (normalmente denominadas precursores o reactivos). A diferencia de la deposición química en fase vapor, los precursores nunca están presentes simultáneamente en el reactor, sino que se introducen como una serie de pulsos secuenciales no solapados. En cada uno de estos pulsos, las moléculas precursoras reaccionan con la superficie de forma autolimitada, de modo que la reacción termina cuando se consumen todos los sitios disponibles en la superficie. Por consiguiente, la cantidad máxima de material depositado en la superficie tras una única exposición a todos los precursores (lo que se denomina ciclo ALD) viene determinada por la naturaleza de la interacción precursor-superficie.[2][3] Variando el número de ciclos es posible cultivar materiales de manera uniforme y con gran precisión en sustratos arbitrariamente complejos y grandes.
ALD es un método de deposición con un gran potencial para producir películas muy finas y conformadas con control del espesor y la composición de las películas posible a nivel atómico. Una de las principales razones del reciente interés por este método son las posibilidades que ofrece para reducir la escala de los dispositivos microelectrónicos de acuerdo con la ley de Moore. El ALD es un campo de investigación muy activo, con cientos de procesos diferentes publicados en la literatura científica,[2][3] [4]aunque algunos de ellos presentan comportamientos que se alejan del proceso ALD ideal.[4] Actualmente existen varios artículos de revisión exhaustivos que ofrecen un resumen de los procesos ALD publicados, entre los que se incluyen los trabajos de Puurunen,[5] Miikkulainen et al, [4] Knoops et al.,[6]y Mackus & Schneider et al.[7] También está disponible en línea una base de datos interactiva de procesos ALD impulsada por la comunidad[1] que genera una visión general actualizada en forma de tabla periódica anotada.
La técnica hermana de la deposición de capas atómicas, la deposición de capas moleculares (LDM), utiliza precursores orgánicos para depositar polímeros. Combinando las técnicas ALD/(LDM, es posible fabricar películas híbridas altamente conformadas y puras para muchas aplicaciones.
Otra tecnología relacionada con la ALD es la síntesis por infiltración secuencial (SIS), que utiliza exposiciones alternas de vapores precursores para infiltrar y modificar polímeros. La SIS también se conoce como infiltración en fase vapor (VPI) e infiltración en fase vapor secuencial (SVI).
Mecanismos de reacción superficial
En un proceso ALD prototípico, un sustrato se expone a dos reactivos A y B de forma secuencial y no solapada. A diferencia de otras técnicas, como la deposición química en fase vapor (CVD), en las que el crecimiento de la capa fina se produce de forma continua, en el proceso ALD cada reactivo reacciona con la superficie de forma autolimitada: las moléculas reactivas sólo pueden reaccionar con un número finito de sitios reactivos de la superficie. Una vez que se han consumido todos esos sitios en el reactor, el crecimiento se detiene. Las moléculas reactivas restantes se eliminan y sólo entonces se introduce el reactivo B en el reactor. Mediante exposiciones alternas de A y B, se deposita una fina película. Este proceso se muestra en la figura lateral. Por consiguiente, cuando se describe un proceso ALD se hace referencia tanto a los tiempos de dosis (el tiempo que una superficie está expuesta a un precursor) como a los tiempos de purga (el tiempo que transcurre entre las dosis para que el precursor evacúe la cámara) para cada precursor. La secuencia dosis-purga-dosis-purga de un proceso ALD binario constituye un ciclo ALD. Además, en lugar de utilizar el concepto de tasa de crecimiento, los procesos de ALD se describen en términos de su crecimiento por ciclo.[8]
En ALD, debe dejarse el tiempo suficiente en cada paso de la reacción para que pueda alcanzarse una densidad de adsorción completa. Cuando esto ocurre, el proceso ha alcanzado la saturación. Este tiempo dependerá de dos factores clave: la presión del precursor y la probabilidad de adherencia.[9] Por tanto, la tasa de adsorción por unidad de superficie puede expresarse como:
Donde R es la tasa de adsorción, S es la probabilidad de adherencia y F es el flujo molar incidente.[10] Sin embargo, una característica clave del ALD es que la S cambiará con el tiempo, a medida que más moléculas hayan reaccionado con la superficie esta probabilidad de adherencia será menor hasta alcanzar un valor de cero una vez alcanzada la saturación.
Los detalles específicos sobre los mecanismos de reacción dependen en gran medida del proceso ALD concreto. Con cientos de procesos disponibles para depositar óxidos, metales, nitruros, sulfuros, calcogenuros y materiales fluorados,[4]el desentrañamiento de los aspectos mecanísticos de los procesos ALD es un campo de investigación activo.[11] A continuación se muestran algunos ejemplos representativos.
ALD térmica
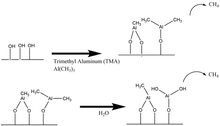
La ALD térmica requiere temperaturas que oscilan entre la temperatura ambiente (~20°C) y los 350°C para el intercambio de ligandos o las reacciones superficiales de tipo combustión.[12] Se produce mediante reacciones superficiales, lo que permite un control preciso del espesor independientemente de la geometría del sustrato (sujeto a la relación de aspecto) y del diseño del reactor[1].
La síntesis de Al2O3 a partir de trimetilaluminio (TMA) y agua es uno de los ejemplos de ALD térmico más conocidos. Durante la exposición al TMA, el TMA se quimisorbe disociativamente en la superficie del sustrato y el TMA restante se bombea fuera de la cámara. La quimisorción disociativa del TMA deja una superficie cubierta de AlCH3. A continuación, la superficie se expone a vapor de H2O, que reacciona con el -CH3 superficial formando CH4 como subproducto de la reacción y dando lugar a una superficie de Al2O3 hidroxilada[1].
ALD asistido por plasma
En el ALD asistido por plasma (PA-ALD), la alta reactividad de las especies de plasma permite reducir la temperatura de deposición sin comprometer la calidad de la película; además, se puede utilizar una gama más amplia de precursores y, por tanto, se puede depositar una gama más amplia de materiales en comparación con el ALD térmico[1].
ALD espacial
En el ALD temporal, las dosis separadas de precursor y co-reactivo se separan en el tiempo mediante un paso de purga. En cambio, en el ALD espacial (s-ALD), estos gases se suministran en lugares diferentes, por lo que están separados en el espacio. En la s-ALD a presión atmosférica, el precursor y el co-reactivo se suministran de forma continua y están separados entre sí por una cortina de gas para evitar reacciones en fase gaseosa. Dicha cortina de gas suele consistir en posiciones de inyección y escape de nitrógeno (véase la figura 1). A medida que un sustrato se desplaza por las distintas zonas de gas, se producen reacciones autolimitadas en la superficie del sustrato y tiene lugar el proceso de ALD. Dado que este proceso puede acelerarse fácilmente, la tasa de deposición para ALD espacial puede ser mucho mayor que para ALD convencional. Por ejemplo, para el ALD de Al2O3, la velocidad de deposición pasa de 100-300 nm por hora a 60 nm por minuto.[5]
La naturaleza en línea del ALD espacial lo hace adecuado para líneas de producción de gran volumen y producción rollo a rollo. En general, el s-ALD se ha empleado para aplicar barreras de permeación de humedad, capas de pasivación en células solares de silicio y capas funcionales en baterías. La química de los procesos ALD espaciales es comparable a la de los procesos ALD temporales típicos, y los materiales que se han explorado incluyen óxidos metálicos inorgánicos como Al2O3, ZnO (dopado con Al o Ga), SiO2, In2O3, InZnO, LIPON, Zn(O,S), SnOx y TiOx ,pero también pueden depositarse metales PMG (Pt, Ir, Ru). Además, las moléculas orgánicas pueden crecer en combinación con átomos inorgánicos para permitir la deposición de capas moleculares (MLD). Se ha demostrado la ALD espacial mejorada con plasma u ozono, que suele reducir las temperaturas de deposición necesarias.
ALD fotoasistida
En esta variedad de ALD, se utiliza luz UV para acelerar las reacciones superficiales en el sustrato. De este modo, la temperatura de reacción puede reducirse, como en el ALD asistido por plasma. En comparación con el ALD asistido por plasma, la activación es más débil, pero suele ser más fácil de controlar ajustando la longitud de onda, la intensidad y el momento de la iluminación[1].
ALD de metal
El ALD de cobre metálico ha atraído mucha atención debido a la demanda de cobre como material de interconexión y a la relativa facilidad con la que el cobre puede depositarse térmicamente.[13] El cobre tiene un potencial electroquímico estándar positivo[14] y es el metal que se reduce más fácilmente de los metales de transición de la primera fila. Por ello, se han desarrollado numerosos procesos de ALD, incluyendo varios que utilizan gas hidrógeno como reactivo principal[13][15]Idealmente, el ALD de cobre metálico debería realizarse a ≤100 °C para conseguir películas continuas con baja rugosidad superficial,[16]ya que temperaturas más altas pueden provocar la aglomeración del cobre depositado.[17]
Algunos metales pueden crecer por ALD mediante reacciones de eliminación de fluorosilano utilizando un haluro metálico y un precursor de silicio (por ejemplo, SiH4, Si2H6) como reactivos. Estas reacciones son muy exotérmicas debido a la formación de enlaces estables Si-F.[11] Entre los metales depositados por eliminación de fluorosilano se incluyen el wolframio[18] y el molibdeno.[19] Como ejemplo, las reacciones superficiales para ALD de wolframio metálico utilizando WF6 y Si2H6 como reactivos pueden expresarse como.[18][20]
- WSiF2H* + WF6 → WWF5* + SiF3H
- WF5* + Si2H6 → WSiF2H* + SiF3H + 2 H2
- La reacción global de ALD es[11]
WF6 + Si2H6 → W + SiF3H + 2 H2, ∆H = –181 kcal
La velocidad de crecimiento puede variar de 4 a 7 Å/ciclo dependiendo de la temperatura de deposición (177 a 325 °C) y de la exposición del reactivo Si2H6 (~104 a 106 L), factores que pueden influir en la inserción del Si2H6 en los enlaces Si-H[21][22]y dar lugar a una contribución del silicio CVD al crecimiento ALD del wolframio.
El ALD térmico de muchos otros metales es un reto (o actualmente imposible) debido a sus potenciales electroquímicos muy negativos. Recientemente, la aplicación de nuevos agentes reductores fuertes ha dado lugar a los primeros informes sobre procesos de ALD térmico a baja temperatura para varios metales electropositivos. El cromo metálico se depositó utilizando un precursor de alcóxido de cromo y BH3(NHMe2).[23]Los metales titanio y estaño se cultivaron a partir de sus respectivos cloruros metálicos (MCl4, M = Ti, Sn) y un compuesto de anillo bis(trimetilsililo) de seis miembros.[24] [25]El aluminio metálico se depositó utilizando un precursor de dihidruro de aluminio y AlCl3.[26]
ALD de SiO2 catalizada

El uso de catalizadores es de vital importancia para conseguir métodos fiables de ALD del SiO2. Sin catalizadores, las reacciones superficiales que conducen a la formación de SiO2 suelen ser muy lentas y sólo se producen a temperaturas excepcionalmente altas. Los catalizadores típicos para la ALD de SiO2 incluyen bases de Lewis como NH3 o piridina y SiO2; la ALD también puede iniciarse cuando estas bases de Lewis se acoplan con otros precursores de silicio como el tetraetoxisilano (TEOS).[11]Se cree que el enlace de hidrógeno se produce entre la base de Lewis y la especie superficial SiOH* o entre el reactivo basado en H2O y la base de Lewis. El oxígeno se convierte en un nucleófilo más fuerte cuando la base de Lewis se une por enlace de hidrógeno con la especie superficial SiOH* porque el enlace SiO-H se debilita de forma efectiva. Como tal, el átomo de Si electropositivo del reactivo SiCl4 es más susceptible al ataque nucleofílico. Del mismo modo, el enlace de hidrógeno entre una base de Lewis y un reactivo H2O hace que el O electronegativo del H2O sea un nucleófilo fuerte capaz de atacar al Si en una especie superficial de SiCl* existente.[27]El uso de un catalizador de base de Lewis es más o menos un requisito para la ALD del SiO2, ya que sin un catalizador de base de Lewis, las temperaturas de reacción deben superar los 325 °C y las presiones deben superar los 103 torr. Generalmente, la temperatura más favorable para realizar la ALD del SiO2 es a 32 °C y una velocidad de deposición común es de 1,35 angstroms por secuencia de reacción binaria. A continuación se presentan dos reacciones superficiales para la ALD del SiO2, una reacción global y un esquema que ilustra la catálisis de la base de Lewis en la ALD de SiO2.Aplicaciones
- Reacciones primarias en la superficie:
- SiOH* + SiCl4 → SiOSiCl3* + HCl
- SiCl* + H2O → SiOH* + HCl Reacción global ALD:
- SiCl4 + 2H2O → SiO2 + 4 HCl
| Tipo de ALD | Temperatura | Precursores viables | Reactantes | Aplicaciones |
|---|---|---|---|---|
| ALD catalítica | >32 °C con catalizador de base Lewis[11] | Óxidos metálicos (es decir TiO2 ZrO2,SnO2)[11] | (Metal)Cl4, H2O[11] | Capas de alto k-dieléctrico, capas protectoras, capas antirreflectantes, etc.[28] |
| Al2O3 ALD | 30–300 °C | Al2O3, óxidos metálicos [29] | (Metal)Cl4, H2O, Ti(OiPr)4, (Metal)(Et)2[11] | Capas dieléctricas, capas aislantes, etc., pasivaciones superficiales de células solares[29] |
| ALD de metales mediante química térmica | 175–400 °C[30] | Fluoruros metálicos, organometálicos, metales catalíticos[30] | M(C5H5)2, (CH3C5H4)M(CH3)3, Cu(thd)2, Pd(hfac)2, Ni(acac)2, H2[30] | Vías conductoras, superficies catalíticas, dispositivos MOS[30] |
| ALD en polímeros | 25–100 °C[11] | Polímeros comunes (polietileno, PMMA, PP, PS, PVC, PVA, etc.)[11] | Al(CH3)3, H2O, M(CH3)3[11] | Funcionalización de superficies poliméricas, creación de compuestos, barreras de difusión, etc.[28] |
| ALD en partículas | 25-100 °C para partículas de polímero, 100-400 °C
para partículas de metal/aleación[11] |
BN, ZrO2, CNTs, partículas poliméricas | Gases diversos: Los reactores de lecho fluidizado se utilizan para permitir el recubrimiento de partículas individuales[28] | Deposición de revestimientos protectores y aislantes, modificación de propiedades ópticas y mecánicas, formación de estructuras compuestas, medios conductores |
| ALD mejorada por plasma o radicales para materiales ALD de un solo elemento | 20–800 °C[11][31] | Metales puros (por ej. Ta, Ti, Si, Ge, Ru, Pt), nitruros metálicos, (por ej. TiN, TaN, etc.)[28] | Organometálicos, MH2Cl2, terbutilimidotris(dietilamido)tántalo (TBTDET), bis(etilciclopentadienil)rutenio), NH3[28] | Estructuras DRAM, dispositivos MOSFET y semiconductores, condensadores[32] |
| ALD mejorada por plasma de óxidos y nitruros metálicos | 20–300 °C | Al2O3, SiO2, ZnOx, InOx, HfO2, SiNx, TaNx[33][34][35] | Similar a la ALD térmica |
Aplicaciones
Aplicaciones microelectrónicas
La ALD es un proceso útil para la fabricación de microelectrónica debido a su capacidad para producir espesores precisos y superficies uniformes, además de la producción de películas de alta calidad utilizando varios materiales diferentes. En microelectrónica, La ALD se estudia como una técnica potencial para depositar óxidos de puerta de altaκ (alta permitividad), dieléctricos de condensador de memoria de alta κ, ferroeléctricos y metales y nitruros para electrodos e interconexiones. En el caso de los óxidos de puerta de alta k, en los que es esencial el control de las películas ultrafinas, es probable que la técnica ALD no comience a utilizarse hasta la tecnología de 45 nm. En las metalizaciones, se requieren películas conformadas; actualmente se espera que la ALD se utilice en la producción general en el nodo de 65 nm. En las memorias dinámicas de acceso aleatorio (DRAM), los requisitos de conformalidad son aún mayores y ALD es el único método que puede utilizarse cuando el tamaño de las características es inferior a 100 nm. Algunos de los productos que utilizan ALD son los cabezales de grabación magnética, las pilas de compuertas MOSFET, los condensadores DRAM, las memorias ferroeléctricas no volátiles y muchos otros.
Referencias
- ↑ a b Kessels, W.M.M. (2019). ALD Database. Eindhoven University of Technology. doi:10.6100/alddatabase.
- ↑ a b Puurunen, Riikka L. (15 June 2005). «Surface chemistry of atomic layer deposition: A case study for the trimethylaluminum/water process». Journal of Applied Physics 97 (12): 121301-121301-52. Bibcode:2005JAP....97l1301P. doi:10.1063/1.1940727.
- ↑ a b Puurunen, Riikka L. (15 June 2005). «Surface chemistry of atomic layer deposition: A case study for the trimethylaluminum/water process». Journal of Applied Physics 97 (12): 121301-121301-52. Bibcode:2005JAP....97l1301P. doi:10.1063/1.1940727.
- ↑ a b c d Miikkulainen, Ville; Leskelä, Markku; Ritala, Mikko; Puurunen, Riikka L. (14 January 2013). «Crystallinity of inorganic films grown by atomic layer deposition: Overview and general trends». Journal of Applied Physics 113 (2): 021301-021301-101. Bibcode:2013JAP...113b1301M. doi:10.1063/1.4757907.
- ↑ a b Puurunen, Riikka L. (15 June 2005). «Surface chemistry of atomic layer deposition: A case study for the trimethylaluminum/water process». Journal of Applied Physics 97 (12): 121301-121301-52. Bibcode:2005JAP....97l1301P. doi:10.1063/1.1940727.
- ↑ Knoops, Harm C. M.; Faraz, Tahsin; Arts, Karsten; Kessels, Wilhelmus M. M. (Erwin) (May 2019). «Status and prospects of plasma-assisted atomic layer deposition». Journal of Vacuum Science & Technology A 37 (3): 030902. Bibcode:2019JVSTA..37c0902K. S2CID 108003079. doi:10.1116/1.5088582. Parámetro desconocido
|doi-access=ignorado (ayuda) - ↑ Mackus, Adriaan J. M.; Schneider, Joel R.; MacIsaac, Callisto; Baker, Jon G.; Bent, Stacey F. (10 December 2018). «Synthesis of Doped, Ternary, and Quaternary Materials by Atomic Layer Deposition: A Review». Chemistry of Materials 31 (4): 1142-1183. S2CID 104385650. doi:10.1021/acs.chemmater.8b02878.
- ↑ "How Atomic Layer Deposition Works". Youtube (2011).
- ↑ Butt, Hans-Jurgen; Graf, Karlheinz; Kappl, Michael (2013). Physics and Chemistry of Interfaces (Third, Revised edición). John Wiley & Sons. ISBN 978-3-527-41216-7.
- ↑ «2.3 Adsorption Kinetics – The Rate of Adsorption». www.chem.qmul.ac.uk.
- ↑ a b c d e f g h i j k l m George, S.M. (2010). «Atomic Layer Deposition: An Overview». Chem. Rev. 110 (1): 111-131. PMID 19947596. doi:10.1021/cr900056b.
- ↑ Güder, Firat (2012). Atomlagenabscheidung unterstützt Nanostrukturelle Transformationen [Atomic layer deposition assisted nanostructural transformations] (Doctoral thesis) (en alemán). University of Freiburg. Front cover image.
- ↑ a b Knisley, Thomas J.; Kalutarage, Lakmal C.; Winter, Charles H. (December 2013). «Precursors and chemistry for the atomic layer deposition of metallic first row transition metal films». Coordination Chemistry Reviews 257 (23–24): 3222-3231. doi:10.1016/j.ccr.2013.03.019.
- ↑ Haynes, William M., ed. (2011). CRC handbook of chemistry and physics : a ready-reference book of chemical and physical data (92nd edición). Boca Raton, FL.: CRC Press. ISBN 9781439855119. OCLC 730008390.
- ↑ Gordon, Peter G.; Kurek, Agnieszka; Barry, Seán T. (2015). «Trends in Copper Precursor Development for CVD and ALD Applications». ECS Journal of Solid State Science and Technology 4 (1): N3188-N3197. ISSN 2162-8769. S2CID 97668427. doi:10.1149/2.0261501jss. Parámetro desconocido
|doi-access=ignorado (ayuda) - ↑ Knisley, Thomas J.; Ariyasena, Thiloka C.; Sajavaara, Timo; Saly, Mark J.; Winter, Charles H. (25 de octubre de 2011). «Low Temperature Growth of High Purity, Low Resistivity Copper Films by Atomic Layer Deposition». Chemistry of Materials 23 (20): 4417-4419. ISSN 0897-4756. doi:10.1021/cm202475e.
- ↑ Guo, Zheng; Li, Hao; Chen, Qiang; Sang, Lijun; Yang, Lizhen; Liu, Zhongwei; Wang, Xinwei (8 de septiembre de 2015). «Low-Temperature Atomic Layer Deposition of High Purity, Smooth, Low Resistivity Copper Films by Using Amidinate Precursor and Hydrogen Plasma». Chemistry of Materials 27 (17): 5988-5996. ISSN 0897-4756. doi:10.1021/acs.chemmater.5b02137.
- ↑ a b Klaus, J.W; Ferro, S.J; George, S.M (February 2000). «Atomic layer deposition of tungsten using sequential surface chemistry with a sacrificial stripping reaction». Thin Solid Films 360 (1–2): 145-153. Bibcode:2000TSF...360..145K. doi:10.1016/S0040-6090(99)01076-7.
- ↑ Seghete, D.; Rayner, G.B.; Cavanagh, A.S.; Anderson, V.R.; George, S.M. (12 de abril de 2011). «Molybdenum Atomic Layer Deposition Using MoF 6 and Si 2 H 6 as the Reactants». Chemistry of Materials 23 (7): 1668-1678. ISSN 0897-4756. doi:10.1021/cm101673u.
- ↑ Grubbs, R. K.; Steinmetz, N. J.; George, S. M. (2004). «Gas phase reaction products during tungsten atomic layer deposition using WF[sub 6] and Si[sub 2]H[sub 6]». Journal of Vacuum Science & Technology B: Microelectronics and Nanometer Structures 22 (4): 1811. Bibcode:2004JVSTB..22.1811G. doi:10.1116/1.1767105.
- ↑ Fabreguette, F.H.; Sechrist, Z.A.; Elam, J.W.; George, S.M. (September 2005). «Quartz crystal microbalance study of tungsten atomic layer deposition using WF6 and Si2H6». Thin Solid Films 488 (1–2): 103-110. Bibcode:2005TSF...488..103F. doi:10.1016/j.tsf.2005.04.114.
- ↑ Elam, J.W; Nelson, C.E; Grubbs, R.K; George, S.M (May 2001). «Kinetics of the WF6 and Si2H6 surface reactions during tungsten atomic layer deposition». Surface Science 479 (1–3): 121-135. Bibcode:2001SurSc.479..121E. doi:10.1016/S0039-6028(01)00969-4.
- ↑ Kalutarage, Lakmal C.; Martin, Philip D.; Heeg, Mary Jane; Winter, Charles H. (28 de agosto de 2013). «Volatile and Thermally Stable Mid to Late Transition Metal Complexes Containing α-Imino Alkoxide Ligands, a New Strongly Reducing Coreagent, and Thermal Atomic Layer Deposition of Ni, Co, Fe, and Cr Metal Films». Journal of the American Chemical Society 135 (34): 12588-12591. ISSN 0002-7863. PMID 23947400. doi:10.1021/ja407014w.
- ↑ Klesko, Joseph P.; Thrush, Christopher M.; Winter, Charles H. (28 de julio de 2015). «Thermal Atomic Layer Deposition of Titanium Films Using Titanium Tetrachloride and 2-Methyl-1,4-bis(trimethylsilyl)-2,5-cyclohexadiene or 1,4-Bis(trimethylsilyl)-1,4-dihydropyrazine». Chemistry of Materials 27 (14): 4918-4921. ISSN 0897-4756. doi:10.1021/acs.chemmater.5b01707.
- ↑ Stevens, Eric C.; Mousa, Moataz Bellah M.; Parsons, Gregory N. (November 2018). «Thermal atomic layer deposition of Sn metal using SnCl 4 and a vapor phase silyl dihydropyrazine reducing agent». Journal of Vacuum Science & Technology A 36 (6): 06A106. Bibcode:2018JVSTA..36fA106S. ISSN 0734-2101. S2CID 104844454. doi:10.1116/1.5055212.
- ↑ Blakeney, Kyle J.; Winter, Charles H. (27 de marzo de 2018). «Atomic Layer Deposition of Aluminum Metal Films Using a Thermally Stable Aluminum Hydride Reducing Agent». Chemistry of Materials 30 (6): 1844-1848. ISSN 0897-4756. doi:10.1021/acs.chemmater.8b00445.
- ↑ Brown, S.; Howe, J.Y.; Ma, Z.; Et (2008). «Surface Modification of Au/TiO2 Catalysts by SiO2 via Atomic Layer Deposition». The Journal of Physical Chemistry C 112 (25): 9448-9457. doi:10.1021/jp801484h.
- ↑ a b c d e Error en la cita: Etiqueta
<ref>no válida; no se ha definido el contenido de las referencias llamadasGeorgeOverview - ↑ a b Werner, Florian; Stals, Walter; Gortzen, Roger; Veith, Boris; Brendel, Rolf; Schmidt, Jan (2011). «Deposición de capas atómicas de alta velocidad de Al2Ol3para la pasivación superficial de células solares de Si». Energy Procedia 8: 1301-306. doi:10.1016/j.egypro.2011.06.140.
- ↑ a b c d Kim, H. (2003). «Atomic layer deposition of metal and nitride thin films: Current research efforts and applications for semiconductor device processing». Journal of Vacuum Science and Technology 21 (6): 2231. Bibcode:2003JVSTB..21.2231K. doi:10.1116/1.1622676.
- ↑ Mackus, Adriaan J. M.; Garcia-Alonso, Diana; Knoops, Harm C. M.; Bol, Ageeth A.; Kessels, Wilhelmus M. M. (2013). «Room-Temperature Atomic Layer Deposition of Platinum». Chemistry of Materials 25 (9): 1769-1774. doi:10.1021/cm400274n.
- ↑ Greer, Frank; Fraser, D.; Coburn, J.W. and Graves, David B. (2002) "Fundamental Vacuum Beam Studies of Radical Enhanced Atomic Layer Chemical Vapor Deposition (REAL-CVD) of TiN". NCCAVS.
- ↑ Potts, S.E.; Kessels, W.M.M. (December 2013). «Energy-enhanced atomic layer deposition for more process and precursor versatility». Coordination Chemistry Reviews 257 (23–24): 3254-3270. doi:10.1016/j.ccr.2013.06.015.
- ↑ Knoops, Harm C. M.; Braeken, Eline M. J.; de Peuter, Koen; Potts, Stephen E.; Haukka, Suvi; Pore, Viljami; Kessels, Wilhelmus M. M. (9 September 2015). «Atomic Layer Deposition of Silicon Nitride from Bis(tert-butylamino)silane and N2 Plasma». ACS Applied Materials & Interfaces 7 (35): 19857-19862. PMID 26305370. doi:10.1021/acsami.5b06833.
- ↑ Langereis, E.; Knoops, H. C. M.; Mackus, A. J. M.; Roozeboom, F.; van de Sanden, M. C. M.; Kessels, W. M. M. (15 October 2007). «Synthesis and in situ characterization of low-resistivity TaNx films by remote plasma atomic layer deposition». Journal of Applied Physics 102 (8): 083517-083517-11. Bibcode:2007JAP...102h3517L. doi:10.1063/1.2798598.

